바텀피싱 반도체 장비주 / 부채 적고 현금많은 회사
레거시 위주의 장비로 전방 레거시 수요가 살아나면 좋아질 회사


24.1Q 원재료 이슈로 안좋았음, 회복 다됨
1분기 YoY 기저로 좋아짐
3분기 양산비용 일회성 비용 (5년에 한번 하는 비용처리 함, 올해 그런거 없음)
4분기 이익률 20% 좋아진건 고사양 본더+레이저 설비 제품 다양화로 좋아졌음 (신제품)
: 기존 저사양본더에서 업그레이드 됨



자회사 피엠티가 다 까먹는중

매출은 24년 다시 회복함 25년은 더 좋아질것
24년에 발주받은 소터 장비 올해 나갈것 240억
기존에 없던 장비로 HBM용 선별 장비임
소터(Sorter) 장비란?
- 반도체 칩, 웨이퍼, 패키지의 자동 선별 및 분류 장비
- 검사(Inspection) 기능 포함 → 불량품 선별, 성능 등급 구분
- 웨이퍼나 칩을 다음 공정으로 자동 이동시켜 생산 공정의 효율성을 높이는 역할
삼성, HBM 품질 혁신…D램 칩 선별공정 도입
삼성전자가 고대역폭메모리(HBM) 품질 혁신을 위한 신공정을 도입한다. HBM의 원재료격인 D램 칩 품질을 선별하는 공정을 신규 추가한다. HBM을 만들기 전 D램을 검사해 나누는 건 반도체 업계에서
www.etnews.com
삼성전자가 고대역폭메모리(HBM) 품질 혁신을 위한 신공정을 도입한다. HBM의 원재료격인 D램 칩 품질을 선별하는 공정을 신규 추가한다. HBM을 만들기 전 D램을 검사해 나누는 건 반도체 업계에서 처음 시도되는 것으로, 삼성전자가 HBM 시장에서 반전의 계기를 마련
25일 업계에 따르면 삼성전자는 D램 칩 품질을 최대 3단계로 나눠 선별할 수 있는 장비(Sorter)를 발주했다. 장비는 프로텍이 공급하는 것으로 파악됐으며, 물량은 20여대 수준으로 알려졌다. 프로텍은 최근 244억원 규모 장비를 계약했다고 공시했다.
HBM은 D램을 수직으로 적층해 만들어지는데, 전공정에서 D램 웨이퍼가 만들어지면 이를 칩별로 자르는 공정(Sawing)을 거친 뒤 칩을 쌓는 본딩(Bonding) 작업이 이뤄진다.
신규 장비는 이들 두 공정 사이에 투입된다. 핵심은 전기적 특성검사(EDS) 후 칩 성능에 따라 최대 3단계로 나누는 것이다. S급, A급, B급으로 D램을 나눠 HBM을 만든다.

레이저 리플로우 장비
솔더(납땜)로 기판에 부착하는 과정에서 레이저를 이용하여 국부적 가열
기존 오븐 방식의 리플로우 공정보다 빠르고 정밀한 국소 가열 가능
열 변형을 최소화하면서 특정 부위만 선택적으로 가열 가능 (워피지 방지)

레이저 본더 : 비메모리 향 주력인데 메모리 쪽도 확대 영업

- 레이저 리플로우: 기존 솔더링 공정을 대체하는 방식으로, 반도체 패키징, 마이크로 LED 제조 등에 활용
- 레이저 본더: 칩과 기판을 직접 접합하는 방식으로, 반도체 웨이퍼 본딩, MEMS 센서, 광학 부품 접합 등에 사용
레이저 리플로우 장비 고객사 세일즈 중
리플로우 + 본더 올해 기대 중
삼전이 투자시작 한다고하니 올해 기대해보자 !!

1. 디스펜서(Dispenser)
1) 사용 목적
- 정밀한 액체(접착제, 솔더 페이스트 등) 도포
- 반도체 패키징, PCB(Printed Circuit Board) 공정, 디스플레이 제조 과정에서 소량의 액체를 고속·정밀하게 도포하는 역할을 수행
2) 주요 사용 분야
- 반도체 패키징: 칩과 기판(PCB) 사이의 접착제 도포
- PCB 조립: 솔더 페이스트, 플럭스(Flux), 언더필(Underfill) 도포
- 디스플레이 패널 생산: OLED, LCD 패널 제조 시 정밀한 접착·도포
- 스마트폰/전장 부품 조립: 스마트폰 내부 칩 부착, 자동차 전장 부품 접착
3) 특징
- 고속/고정밀 도포 기술 적용 (마이크로리터(μL) 단위의 정밀 분사 가능)
- 자동화 공정에서 생산성 극대화
- 다양한 점도의 액체를 균일하게 도포 가능

다이본딩장비/레이저본딩장비


2. 다이본더(Die Bonder)
1) 사용 목적
- 반도체 칩을 기판(PCB, 웨이퍼, 리드 프레임 등)에 부착하는 장비
- 반도체 칩이 안정적으로 장착될 수 있도록 접착제, 솔더, 에폭시 등을 활용하여 부착 작업을 수행
2) 주요 사용 분야
- 반도체 패키징 공정: 웨이퍼에서 개별 칩(Die)을 절단 후, 기판이나 리드프레임에 부착
- MEMS(미세전자기계시스템) 및 센서 제조: IoT 기기, 자동차 전장 시스템용 반도체 센서 부착
- 광학 부품 및 LED 제조: LED 칩을 PCB 기판에 부착
3) 특징
- 고정밀 정렬(Alignment) 기술 적용 → 10㎛ 이하 정밀도
- 고속 본딩 → 생산성 증가
- 열경화·UV경화 본딩 지원 → 다양한 접착 방식 대응
3. 레이저 리플로(Laser Reflow)
1) 사용 목적
- 레이저를 이용한 비접촉식 고속 납땜(Reflow Soldering) 공정
- 기존 오븐 방식 대비 국부적으로 신속한 가열 가능 → 정밀한 온도 제어 가능
2) 주요 사용 분야
- 반도체 패키징 공정: 플립칩(Flip Chip), CSP(Chip Scale Package) 등의 접합
- PCB 부품 조립: 고밀도 부품을 장착한 기판의 솔더링 공정
- 마이크로 LED 및 OLED 제조: 초정밀 전자 소자의 리플로 솔더링
- 5G 및 RF(무선통신) 모듈 제조: 고주파 기기용 초미세 부품 연결
3) 특징
- 기존 열풍·적외선(IR) 방식 대비 비접촉식 고속 가열 가능
- 특정 부위만 선택적으로 가열 → 열 변형 최소화
- 기존 솔더링 공정보다 미세한 부품 및 고밀도 패키징에 유리

피엠티(구 마이크로프랜드) 올해 BEP 된다!
번인용 프로브 카드가 주업 (삼성향 단독 납품)
전체 프루브카드 중 번인 프루부카드 비중은 좋을때 20%까지 적을때는 10% 수준
삼전 HBM 올해 시작하면 HBM용 프루브카드 PO 시작하겠지...

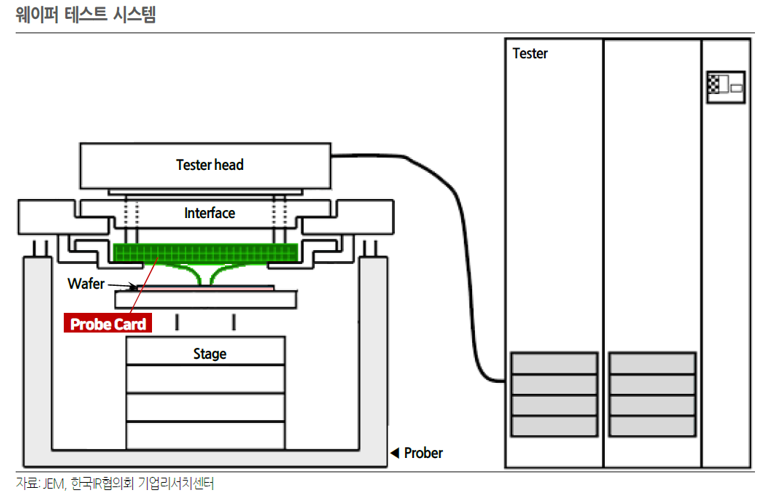
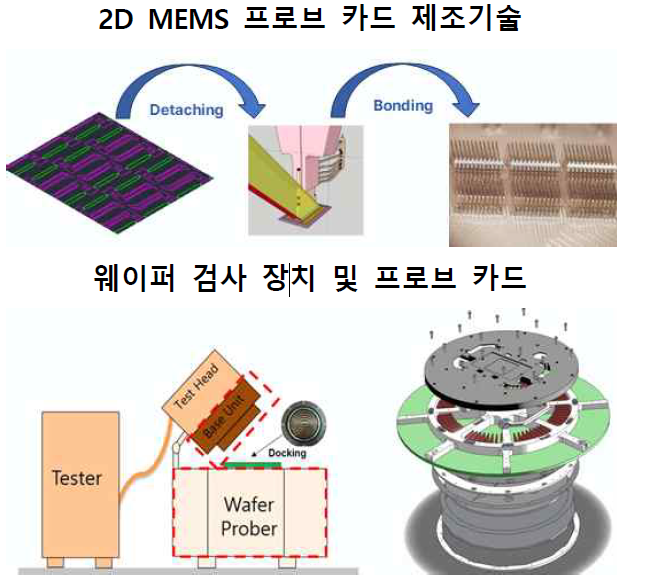
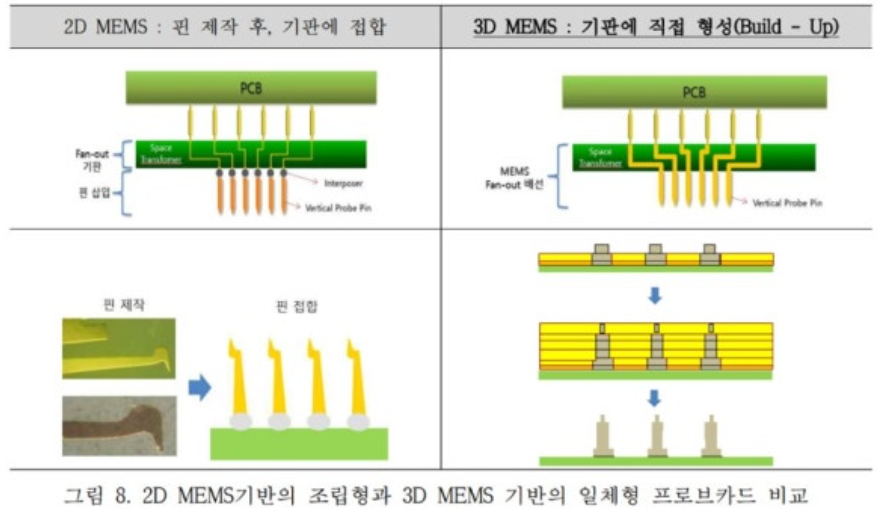
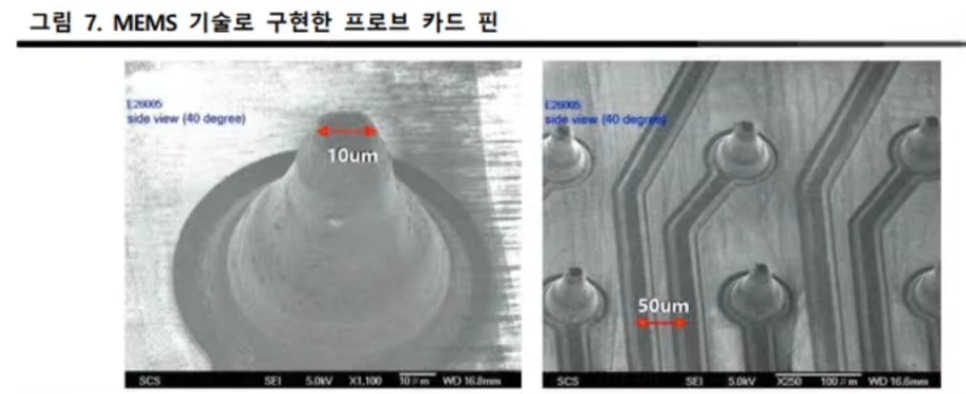
2D 방식은 70um 피치에서 한계점을 드러내고 있고 프로브 핀수가 15000개를 넘어서면 조립형(2D)에서 일체형(3D MEMS)으로 넘어가는 추세이다. (메모리, 비메모리 모두 사용 가능)

'경제_재테크_투자_주식' 카테고리의 다른 글
| 250321 투자아이디어스크랩 - 반도체 단기 급등... 빠지면 담아도될것 (1) | 2025.03.24 |
|---|---|
| 250321 투자아이디어스크랩 - 반도체 단기 급등... 빠지면 담아도될것 (0) | 2025.03.22 |
| LS전선 해저케이블 사업 초격차 전략 (0) | 2025.03.19 |
| 250319 엔터사들 정리 (0) | 2025.03.19 |
| 240318 투자아이디어 스크랩 (0) | 2025.03.19 |


